
La tecnología de fotolitografía de ultravioleta extremo (UVE) creada por la empresa neerlandesa ASML es de una complejidad excepcional. Estos equipos son utilizados actualmente por gigantes como TSMC, Samsung, Intel, SY Hynix, y Micron Technology para la producción de circuitos integrados de última generación. En sus inicios, en los años 90, muchos ingenieros de ASML dudaban de la posibilidad de desarrollar estos equipos.
El cambio de perspectiva llegó en 1997, cuando Jos Benschop, líder del departamento de investigación, reconsideró la factibilidad de la tecnología UVE. Tras las primeras pruebas, descubrió que Zeiss, una empresa alemana, podía fabricar los espejos altamente sofisticados necesarios para manejar la luz ultravioleta. Este fue el verdadero inicio de la tecnología que posibilita que nuestros dispositivos actuales tengan chips tan avanzados.
El Hito de Zeiss en los 90
Uno de los componentes más complejos en las máquinas de litografía UVE es la fuente de luz ultravioleta, producida por Cymer, una empresa de origen estadounidense que ASML adquirió en 2013 para acelerar el desarrollo de esta tecnología. Un detalle relevante: la luz ultravioleta se utiliza para transferir con gran precisión el patrón geométrico de la máscara a la oblea de silicio.
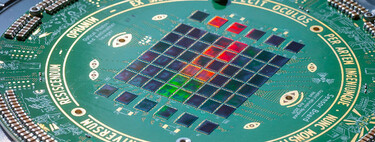
La máscara es simplemente una plantilla física que contiene el diseño del circuito integrado que debe transferirse a la oblea de silicio. Sin embargo, hay otro conjunto de componentes, los espejos, cuya producción es esencial para esta tarea. Estos espejos, que en 1997 Jos Benschop pensó que Zeiss podría producir, son fundamentales para el proceso.
La luz de 11,4 nm fue descartada debido a la toxicidad del berilio en los espejos
Los elementos ópticos fabricados por Zeiss son cruciales en estos equipos de litografía, ya que trasladan la luz UVE con una longitud de onda de 13,5 nm desde la fuente hasta la máscara. Si los espejos no son fabricados con precisión extrema, el patrón geométrico de la máscara podría alterarse, dañando los chips.
Seleccionar la longitud de onda de la luz UVE fue una decisión delicada. Inicialmente, se consideraron longitudes de onda de 13,5 nm, 11,4 nm, 6,6 nm y 4,8 nm, pero las dos últimas fueron descartadas debido a las limitaciones de los materiales fotorresistentes. La opción de 11,4 nm se eliminó porque requería usar berilio, un material tóxico, en los espejos.
Finalmente, la opción de 13,5 nm fue la elegida, requiriendo el uso de molibdeno y silicio en los espejos, materiales sin problemas de toxicidad. Este dato subraya el alto nivel de precisión necesario en la fabricación de estos espejos: Zeiss aplica iones de argón para pulir los espejos capa por capa a nivel atómico y utiliza técnicas de análisis subnanométrico para detectar y corregir cualquier defecto.

* Algún precio puede haber cambiado desde la última revisión
Imagen | Zeiss
Bibliografía | ‘Focus: The ASML Way’, de Marc Hijink
Más información | Zeiss | Asianometry

Deja una respuesta